FHR ALD 300
原子层沉积
精确控制原子单层堆叠的成长
ALD反应器工具的特质:
客制化独立的气路控制配置

FHR Anlagenbau GmbH是真空制程及薄膜技术的创新型企业.公司建立于1990年德国德累斯顿,由拥有资深设计设备背景及技术工程的团队创建并致力于真空制程技术和特殊设备制造的创新型企业.凭借多年来在薄膜技术领域积累的经验,可提供全世界薄膜应用领域最先进的客户解决方案以及定制设备设计方案.
FHR技术组合包括:
- 先进的磁控溅射和CVD金属化技术
- 反应式溅射技术应用于氧化物及氮化物的沉积
- 先进的蚀刻技术藉由高密度的FLA电浆来源并应用于半导体,金属,陶瓷,纳米结构及光子材料的处理和改性
- 原子层沉积(ALD)用于精确控制单层堆叠的生长,并在复杂的三维形状上具有优异的厚度均匀性
此外聚集式(cluster type)及卷对卷式可应用于小尺寸及软性基材,FHR提供整合性系统针对大面积涂布及供应高品质溅射靶材.FHR Anlagenbau GmbH公司于2008年成为Centrotherm International AG全资控股的子公司,该公司是太阳能电池和太阳能矽片生产技术和服务领域的顶级国际供应商。
超薄膜沉积需使用优秀并均匀性的特殊沉积技术原子层沉积(ALD)建立于顺序饱和表面反应提供了一种合适的技术,使其成为化学气相沉积技术中独特的涂层方法。原子层沉积是由至少两种化学反应物(前体)的交替基材暴露来进行的。首先将一个前体物冲洗在基底上.
前体与反应性表面点(化学吸附)反应,直到不再有未反应的表面位点(饱和).接下来使用惰性气体清除第一前体物的气态反应残余物。然后冲洗第二种前体并再次发生表面反应直至达到饱和。在清除第二前体的反应残余物之后,再次循环并执行冲洗的第一前气体。
在ALD制程中互补和自限性表面反应可提供控制厚度在纳米级以下的均匀薄膜,以及在复杂三维表面形状上具有优异的薄膜阶梯覆盖率.针对ALD制程FHR Anlagenbau GmbH公司提供定制反应器工具,专为研发活动和工业规模的批量生产而设计.
ALD制程的优点
- 沉积50nm至1nmnm超薄膜沉积超高均匀性厚度
- 低压制程温度:
- 均匀性的原子单层排列
- 在复杂的3D形状中具有优秀均匀性的厚度
- 广泛用途领域的先驱
典型的沉积薄膜物质
- 氧化物:HfO₂, Al₂O₃, La₂O₃, SiO₂ …
- 氮化物: TiN, TaN, SiNx…
- 金属: W, Ta, Cu, Ru
Al₂O₃原子层循环沉积的范例

ALD 300
研发解决方案可选择性的原位分析

Wafer diameter晶圆直径
- 150, 200, 300 mm
Loading承载
- 手动,一个基材,无尘室进入站别
Number of handling chambers多数的处理腔体
- 一
Handling chamber处理腔体
- 铝,加热至80°C,四个端口
Number of load locks进样数量
- 一
Load lock进样
- 氮气冷却并带有一个勾槽
Number of process chambers多数的制程腔体
- 二
Process chamber 1制程腔体1
- 铝,加热至200°C
- 氩气清洁窗口
- 气体淋头(shower head),两个气体通道
- 中央进气口
- 基材加热至600°C
- 椭圆测量端口
Process chamber 2制程腔体2
- 铝,加热至150°C
- 钛,加热至200°C(固定腔体)
- 气体横向流动,两个气体通道
- 灯源加热器:直径100mm,最高至1000°C
- 基材加热至500°C
Gas system气体系统
Process chamber 1制程腔体1
- 4条前驱气体管道(加热至200°C / 230°C)
- 4条起泡器(1个冷却,3个加热)
- 7条气体线,2条气体线为储备线
Process chamber 2制程腔体2
- 4条前驱气体管道(加热至200°C / 230°C),2条备用端口.
- 4条起泡器(2个冷却,2个加热)
- 2条气体线,2条气体线为储备线
ALD 300
晶圆厂工业解决方案
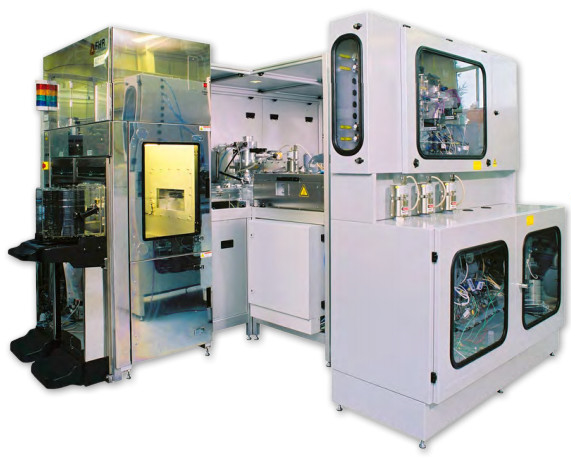
Wafer diameter晶圆直径
- 300 mm
Loading承载
- 标准晶圆堆叠(25个)
Number of handling chambers多数的处理腔体
- 一
Handling chamber处理腔体
- 铝,加热至80°C,四个端口
Number of load locks进样数量
- 一
Load lock进样
- 氮气冷却并带有两个勾槽
Number of process chambers:多数的制程腔体
- 二
Process chamber 1制程腔体1
- 铝,加热至200°C,氩气清洁窗口
- 气体淋头(shower head),两个气体通道
- 气体横向流动,两个气体通道
- 基材加热至600°C(横向流动:最高至400°C)
Process chamber 2制程腔体2
- 铝,加热至200°C
- 气体淋头,两个气体通道
- 气体横向流动,两个气体通道
- 远距电浆系统
- 基材加热至600°C(横向流动:最高至400°C)
Gas system气体系统
Process chamber 1制程腔体1
- 4条前驱气体管道(加热至200°C / 230°C),1条备用端口.
- 4条起泡器(1个冷却,3个加热)
- 5条气体线,4条气体线为储备线
- 液体冲洗
Process chamber 2制程腔体2
- 5条前驱气体管道(加热至200°C / 230